

・可提供Pad中心距在35μm以内的倒装芯片(外围封装)
・可提供结构为1-2-1,厚度为0.3mm以下的薄型载板
・可提供无铅、无氟等绿色产品
・可提供多种表面处理方式(镀金、无铅焊料涂层、OSP等)
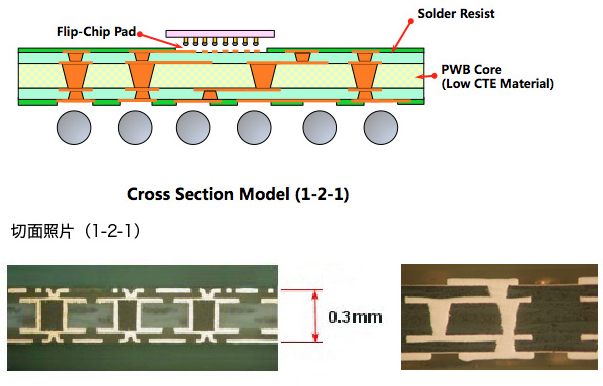
| 项目 | 规格(Unit:μm) | |
| Layer Structure | Up to 3-n-3 | |
| Build-up Line Width / Space | 17 / 18 | |
| Build up Insuiation Thickness | 30 | |
| Pad Pitch (Peripheral) | 35 | |
| Via Hole Diameter | 60 | |
| Via Pitch | 190 |
*该数据可能会在无预先通告情况下发生变动。
・功能手机・智能手机用FCCSP
・数码相机用FCCSP
市场领域
产品展示


