
京瓷开发了相比传统材料,具有更高热阻,高散热性,高耐压及高载流能力的新型TO 陶瓷封装外壳。我司产品可为新一代功率半导体器件如碳化硅(SiC)提供封装解决方案,其为能量转换应用方面的关键器件。
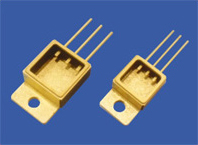


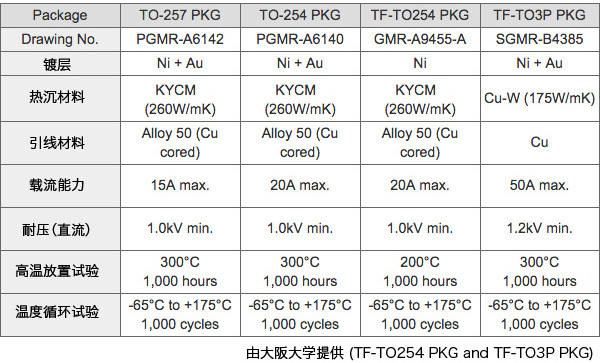
注释:1.氧化铝陶瓷材料(京瓷A440)
2.电镀选项:Ni 电镀或 Ni+Au 电镀
3.载流能力定义于引线温度最高80℃
4.高温放置及温度循环试验由京瓷进行测试。
5.通过外观检查及耐压测试规格来判定。

作为新型TO陶瓷陶瓷封装我司开发及可提供大规模混合电路封装外壳。
我司可按照您的要求做定制产品。
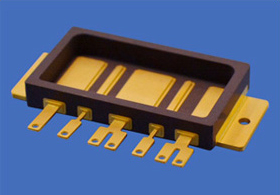
由大阪大学提供(TF-HB PKG)
TF-HB PKG
・ 图号: GMR-B1372
・ 电镀: Ni+Au
・ 热沉材料: Cu-W(175W/mk)
・ 芯腔底板材料: Cu
・ 引脚材料: Cu
・ 载流能力: 50A max.
・ 耐压(DC): 1.5kV min.
・ 温度循环试验: -65℃~+175℃ 1000 cycles
市场领域
产品展示


